- Главная
- Разное
- Дизайн
- Бизнес и предпринимательство
- Аналитика
- Образование
- Развлечения
- Красота и здоровье
- Финансы
- Государство
- Путешествия
- Спорт
- Недвижимость
- Армия
- Графика
- Культурология
- Еда и кулинария
- Лингвистика
- Английский язык
- Астрономия
- Алгебра
- Биология
- География
- Детские презентации
- Информатика
- История
- Литература
- Маркетинг
- Математика
- Медицина
- Менеджмент
- Музыка
- МХК
- Немецкий язык
- ОБЖ
- Обществознание
- Окружающий мир
- Педагогика
- Русский язык
- Технология
- Физика
- Философия
- Химия
- Шаблоны, картинки для презентаций
- Экология
- Экономика
- Юриспруденция
Ограничения уменьшения размеров МОП транзистора. (Лекция 2) презентация
Содержание
- 1. Ограничения уменьшения размеров МОП транзистора. (Лекция 2)
- 2. Зависимость выхода годных Y от минимального размера L м Y Lm
- 3. Закон сохранения выхода годных
- 4. 1. Ограничения, связанные с дисперсией размеров пыли
- 5. Зависимость числа осажденных пылинок от их размера
- 6. Влияние размера дефекта и элемента на отказ ИС
- 7. Влияние размеров дефектов на степень интеграции ИС (Поражающи)
- 8. Учет влияния дисперсии размеров дефектов на выход
- 9. 2. Приборные (параметрические ) ограничения
- 10. Ограничения, связанные со смыканием областей
- 11. Зависимость ширины ОПЗ от концентрации примеси и
- 12. Логика закона масштабирования ?
- 13. Зависимость ширины ОПЗ от концентрации примеси и
- 14. Пороговое напряжение МОП-транзистора
- 15. Логика закона масштабирования ?
- 16. Пороговое напряжение МОП-транзистора
- 17. Логика закона масштабирования ?
- 18. Логика закона масштабирования
- 19. Влияние масштабирования на параметры ИС K
- 20. График закона масштабирования
- 21. Ограничение графика закона масштабирования
- 23. Зависимость величины туннельного тока через диэлектрик от напряжения на затворе [2]
- 24. Зависимость ширины и длины канала от
- 25. Изменение толщины подзатворного диэлектрика Технологические поколения. мкм Альтернативные диэлектрики [2] Альтернативный диэлектрик
- 26. Использование альтернативных диэлектриков
- 27. Влияние диэлектрической проницаемости альтернативного диэлектрика на физическую толщину подзатворного диэлектрика
- 28. Микрофотография структуры с оксидом гафния
- 29. Ограничения, связанные с потерей полупроводником диэлектрических свойств
- 30. Ограничения, связанные с потерей полупроводником диэлектрических свойств p n Xопз
- 31. Электроперенос, ограничивающий масштабированное уменьшение толщины проводящих пленок
- 32. Конструктивные особенности масштабируемой системы металлизации Толщина металлизации не масштабируется!
- 33. Конструктивные особенности масштабируемой системы металлизации
- 34. РЭМ - фотография металлизированной разводки
- 35. Ограничения, связанные с отводом тепла
- 36. Предельные значения физических параметров
- 37. График закона масштабирования с учетом физических ограничений
- 38. Ограничения уменьшения размеров традиционного МОП транзистора [1]
- 39. 4. Технологические ограничения, связанные с процессом совмещения при литографии
- 40. Установка совмещения и экспонирования на участке фотолитографии
- 41. Таблица факторов, определяющих ПДР ( I =
- 42. Масштабируемость ПДР Для ячейки МОП ИС ЗУ
- 43. Таблица факторов, определяющих ПДР ( I =
- 44. Электроперенос, ограничивающий масштабированное уменьшение толщины проводящих пленок
- 45. Конструктивные особенности масштабируемой системы металлизации
- 46. РЭМ - фотография металлизированной разводки
- 47. Причина немасштабируемости линии при литографии
- 48. Методы самосовмещения в технологии ИС
- 49. Самосовмещение с разнотолщинной маской с использованием открытого
- 50. Влияние температуры и среды на перераспределение примеси
- 51. Инверсионный канал по краю кармана р-типа [2]
- 52. Распределение примеси по глубине при ионной имплантации Концентрация Глубина, мкм
- 53. Самосовмещение с разнотолщиной маской с использованием ионной
- 54. Самосовмещение с помощью твердой маски Ионная имплантация
- 55. Самосовмещение с использованием электродов в качестве
- 56. Самосовмещение с использованием легированного поликремниевого электрода
- 57. Самосовмещение с помощью «спейсеров»
- 58. Самосовмещение с использованием Lift off («взрывной») технологии
- 59. Самосовмешение с использованием бокового подтравливания и «взрывной»
- 60. Перекрестная металлизация
- 61. Самосовмещенный процесс создания перекрестной металлизации
- 62. Самосовмещенный процесс создания перекрестной металлизации
- 63. Самосовмещенный процесс создания перекрестной металлизации
- 64. Самосовмещенный процесс создания перекрестной металлизации
- 65. Самосовмещенный процесс создания перекрестной металлизации
- 66. Самосовмещенный процесс создания перекрестной металлизации
- 67. Фундаментальные физические ограничения уменьшения размеров [1]
Слайд 41. Ограничения, связанные с дисперсией размеров пыли Зависимость числа осажденных пылинок от
Долят
в общем
объеме
воздуха
R
Размер частицы
Т – технологический фактор
Слайд 5Зависимость числа осажденных пылинок от их размера
в общем
количестве
1/Rт т – технологический
фактор
Размер пылинки
R
Слайд 8Учет влияния дисперсии размеров дефектов на выход годных ИС.
Если D0 = D /lт где D – constant, l – минимальный топологический размер. т – технологический фактор,
и Аэ = l2N , где N – число квадратов со стороною l , определяющих площадь элемента и тогда
Y = exp (- l2NMD/lт ) = exp (- NMD/lт-2 )
Рациональный путь повышения М – увеличение значения технологического фактора - т!
Слайд 10 Ограничения, связанные со смыканием областей ОПЗ истока и стока при уменьшении
Слайд 19Влияние масштабирования на параметры ИС
K - коэффициент масштабирования,
Lk, Wк, Xок , Wмс, Hpn 1/k
Nп k
Uст 1/k
E 1 !
Iст 1/k ( на один транзистор)
tз 1/k !
P 1/k2 (на один транзистор) !
Ptз 1/k3 ( энергия затрачиваемая на операцию с 1 битом )
Rмс K ( при уменьшении лишь ширины дорожки межсоединений)
Cмс 1/k
Tз мс (Rм Cм) 1 !
Слайд 22
3. Физические ограничения
Слайд 24Зависимость ширины и длины канала от толщины подзатворного оксида кремния
(
Длина канала
Ширина канала
Слайд 25Изменение толщины подзатворного диэлектрика
Технологические поколения. мкм
Альтернативные диэлектрики
[2]
Альтернативный диэлектрик
Слайд 26 Использование альтернативных диэлектриков
Эффективная толщина подзатворного диэлектрика
Тэ = Тд кок / кд
Тэ - эффективная толщина подзатворного диэлектрика
Tд – толщина альтернативного диэлектрика
кд и кок - коэффициенты диэлектрической проницаемости альтернативного диэлектрика и оксида кремния
Слайд 27Влияние диэлектрической проницаемости альтернативного диэлектрика на физическую толщину подзатворного диэлектрика
Слайд 29Ограничения, связанные с потерей полупроводником диэлектрических свойств
4
3
2
1
0
2 В
5В
Зависимость ширины ОПЗ
концентрации примеси и напряжения смещения
Слайд 31Электроперенос, ограничивающий масштабированное уменьшение толщины проводящих пленок
+
tот = J-n
где tот - время до отказа ( час ), J – плотность тока ( А/см2), n - коэффициент ( 1 – при малом токе, 3 – при большом токе).
При J = 106 А/см2 , tот= 3 месяца.
Слайд 32Конструктивные особенности масштабируемой системы металлизации
Толщина металлизации не масштабируется!
Слайд 41Таблица факторов, определяющих ПДР ( I = 3 мкм )
ПДР –
Слайд 43Таблица факторов, определяющих ПДР ( I = 3 мкм )
ПДР –
Слайд 44Электроперенос, ограничивающий масштабированное уменьшение толщины проводящих пленок
+
tот = J-n
где tот - время до отказа ( час ), J – плотность тока ( А/см2), n - коэффициент ( 1 – при малом токе, 3 – при большом токе).
При J = 106 А/см2 , tот= 3 месяца.
Слайд 47Причина немасштабируемости линии при литографии
М
Толщина пленки не масштабируется, что обуславливает постоянство
ПДР
ПДР
Слайд 48Методы самосовмещения
в технологии ИС
Self Aligned
PSA, APSA, NSA, QSA, SST, VIST. SWAMI. SICOS
Слайд 49Самосовмещение с разнотолщинной маской
с использованием открытого травления
Самосовмещение «Полный эмиттер»
Традиционный маршрут
Критичная фотолито- графия
Диффузия фосфора
n
n
n
p
p
p
n
Открытое травление оксида
Диффузия фосфора
n
n
n
p
p
n
p
Слайд 50Влияние температуры и среды на перераспределение примеси при окислении кремния
Коэффициент
сегрегации
1017 см-3
ДА Нет
Инверсный канал
Слайд 51Инверсионный канал по краю кармана р-типа
[2]
1018
1017
1016
Латеральная диффузия бора
Рабочая
Инверсный слой
Охранная область
Р
Слайд 53Самосовмещение с разнотолщиной маской с использованием ионной имплантации
Ионная имплантация бора
Инверсный канал
Охранная
область
Самосовмещенная структура
p
Латеральная
диффузия бора
Слайд 54Самосовмещение с помощью твердой маски
Ионная имплантация бора
Ионная имплантация фосфора
п
п
п
р
р
П+
Слайд 56Самосовмещение с использованием легированного поликремниевого электрода
n+
Поликремний, легированный мышьяком
x
э-ф
хим
Слайд 57Самосовмещение с помощью «спейсеров»
Ионная имплантация фосфора
Ионная имплантация мышьяка
n
n
n
n
n+
n+
Конформное осаждение
Слайд 58Самосовмещение с использованием Lift off («взрывной») технологии
Жертвенный слой
Ионная имплантация бора
Осаждение оксида
Растворение
Ионная имплантация фосфора
Удаление оксида
n
p
n
p
n
p
n
p
n
p
Слайд 59Самосовмешение с использованием бокового подтравливания и «взрывной» технологии
жертвенный слой и оксид
Ионная
Боковое подтравливание жертвенного слоя
Конформное осаждение оксида
Растворение жертвенного слоя – «взрыв»
Ионная имплантация фосфора
Удаление оксида
n
n
n
n
n
n
p
p
p
p
p
p
Слайд 60 Перекрестная металлизация
1. Вскрытие окон
под диффузию
2.Формирование
М1
3. Вскрытие окон
под контакты
4.Формирование
М2
p
p
n
M2
M1
n
p
p
Слайд 61Самосовмещенный процесс создания перекрестной металлизации
Фоторезист
Нитрид магния ( перекисно-аммиачная смесь)
Пиролитический оксид кремния ( плавиковая кислота)
Полиимид ( кислородная плазма)
Термический оксид кремния ( плавиковая уислота)
Кремний ( п-типа)
Слайд 62Самосовмещенный процесс создания перекрестной металлизации
Последовательное
и боковое подтравливание
в специфических травителях
и удаление фоторезиста
Слайд 63Самосовмещенный процесс создания перекрестной металлизации
РИО
алюминия
Растворение нитрида магния
Слайд 64Самосовмещенный процесс создания перекрестной металлизации
РИО
нитрида
кремния
Растворение оксида
( взрыв нитрида кремния и вскрытие окон под диффузию)









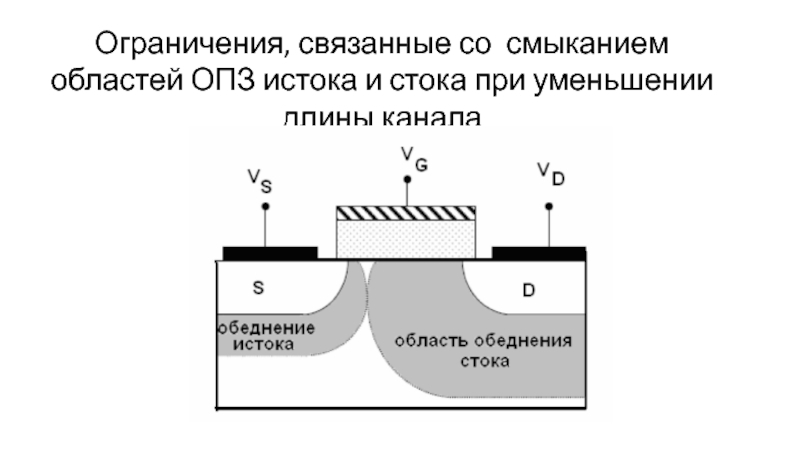












![Зависимость величины туннельного тока через диэлектрик от напряжения на затворе[2]](/img/tmb/4/368620/9ede462a629d5f73e6f7575a4f3ad9de-800x.jpg)

![Изменение толщины подзатворного диэлектрикаТехнологические поколения. мкмАльтернативные диэлектрики[2]Альтернативный диэлектрик](/img/tmb/4/368620/91fe06851d59eb15ae79f107bea4e976-800x.jpg)

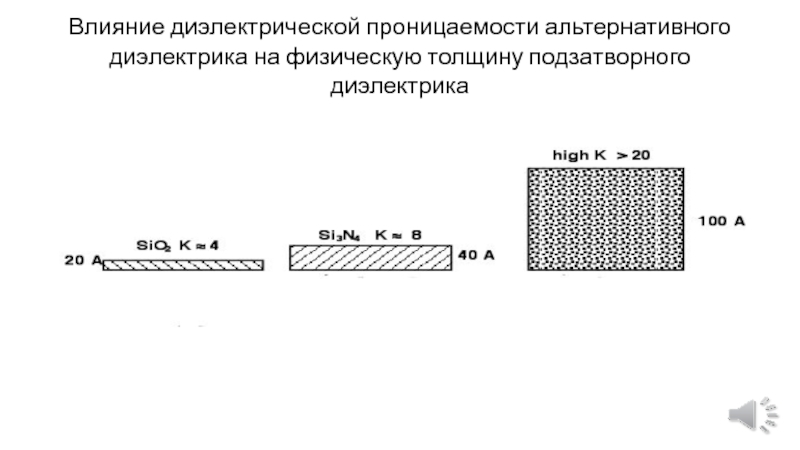
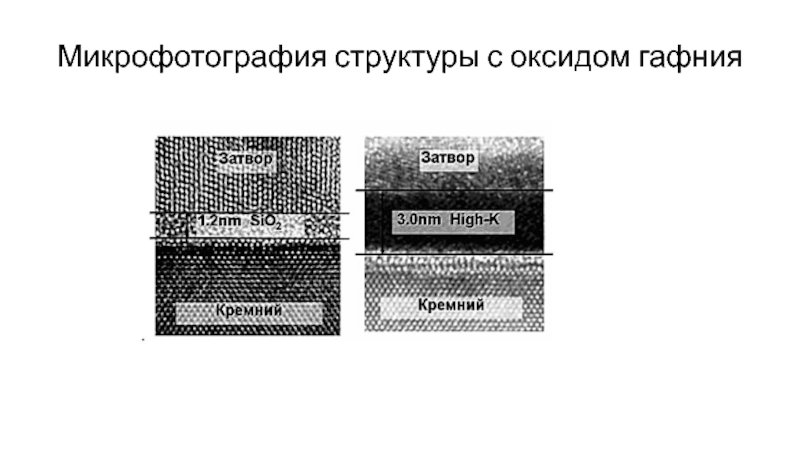



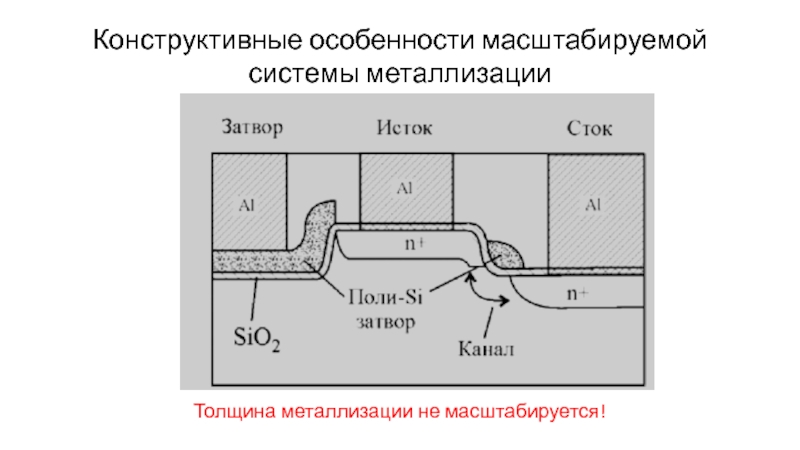

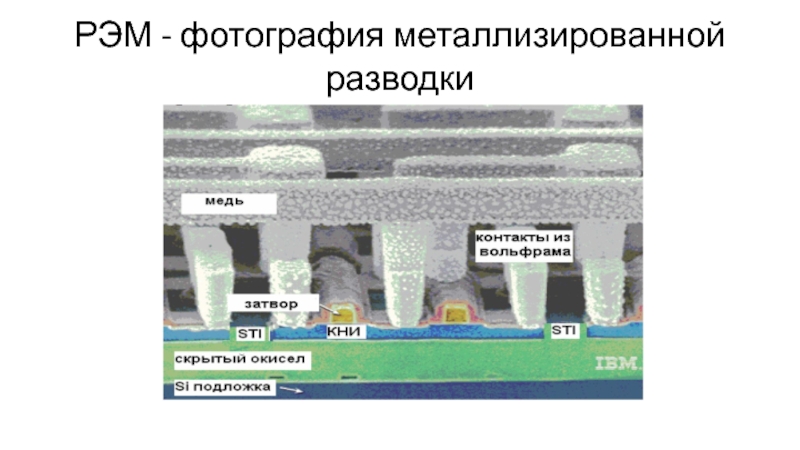



![Ограничения уменьшения размеров традиционного МОП транзистора[1]](/img/tmb/4/368620/d90dd7b7014aae2a7d92dc4756ef6a19-800x.jpg)

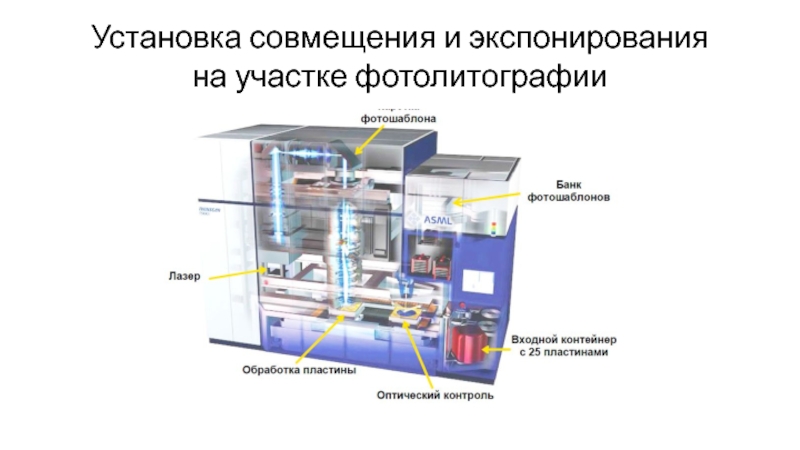




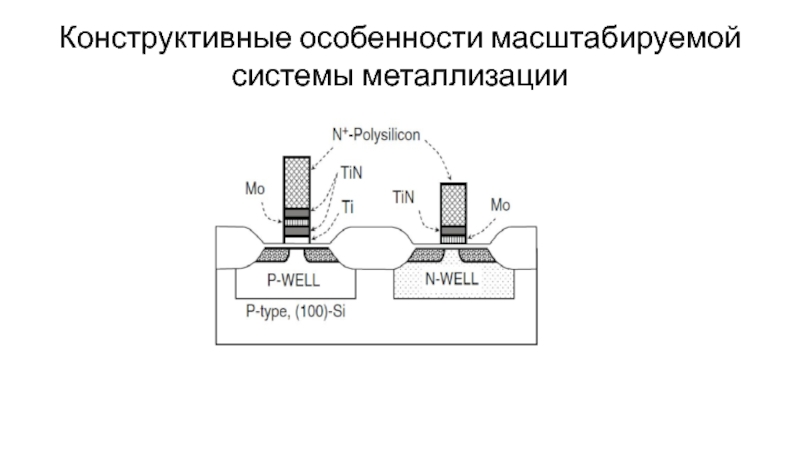
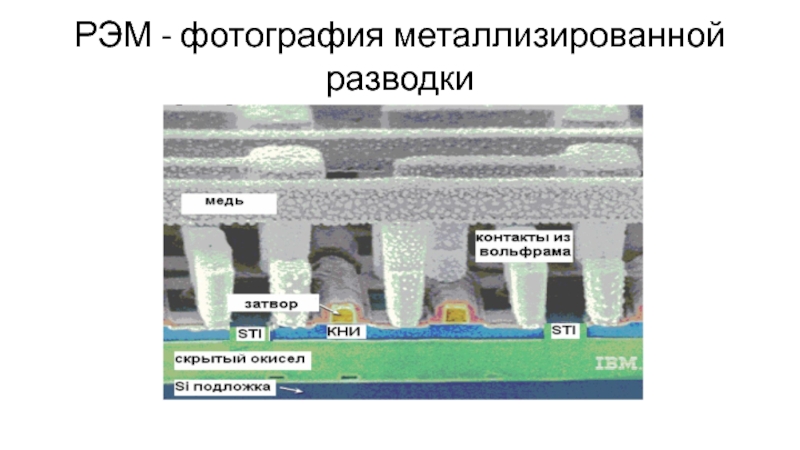
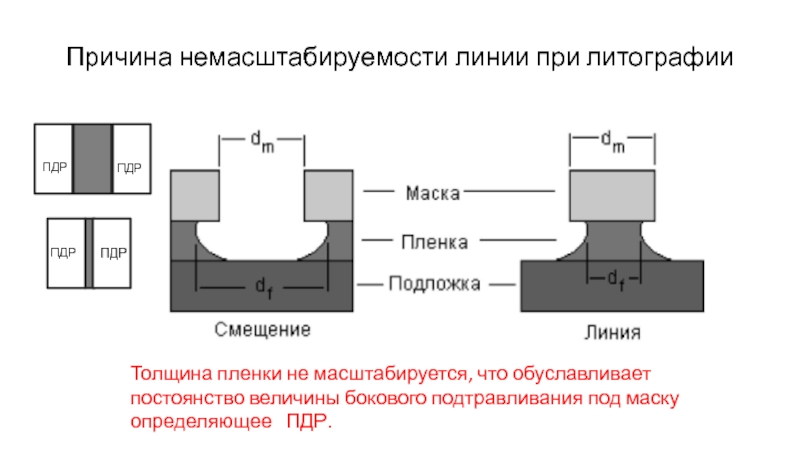



![Инверсионный канал по краю кармана р-типа[2]1018 10171016Латеральная диффузия бораРабочая область транзистораИнверсный слойОхранная областьР](/img/tmb/4/368620/6947479d13c4cf661b6462a58a7e5b70-800x.jpg)






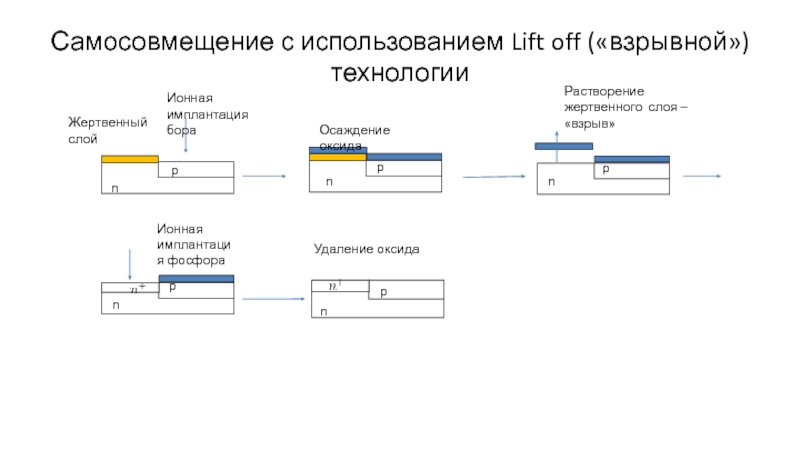

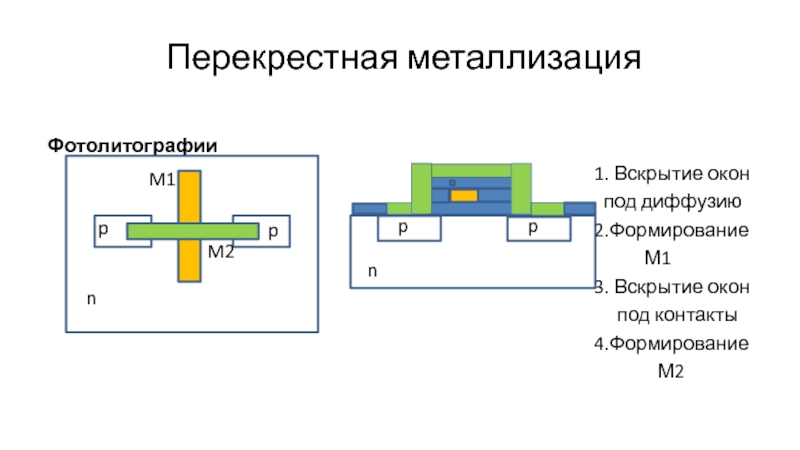


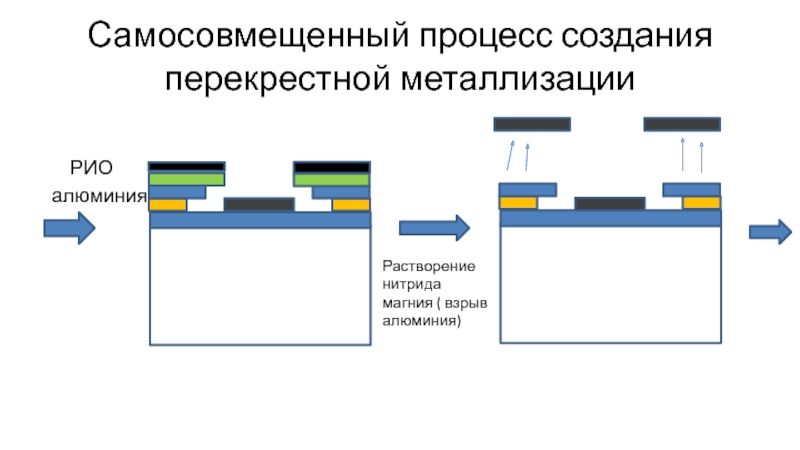
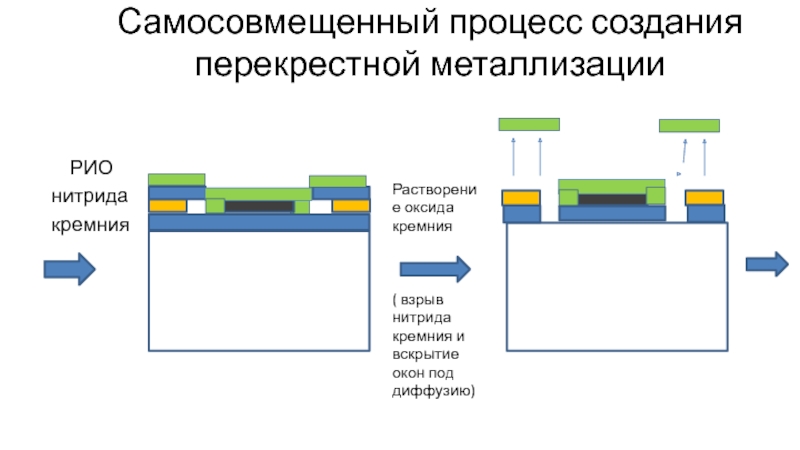
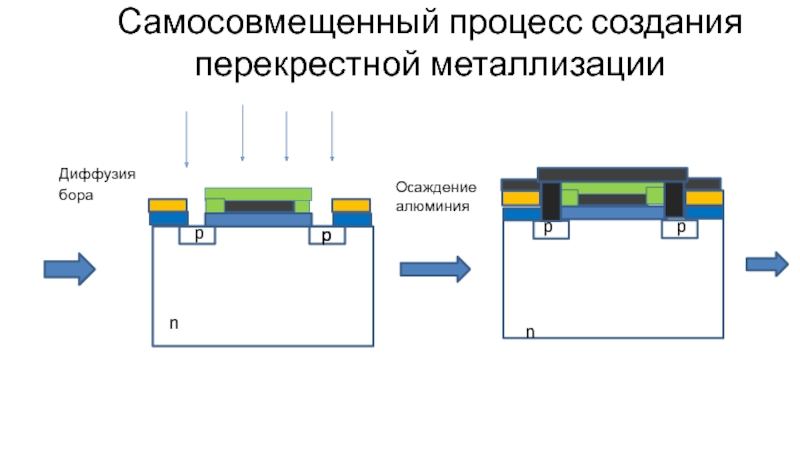
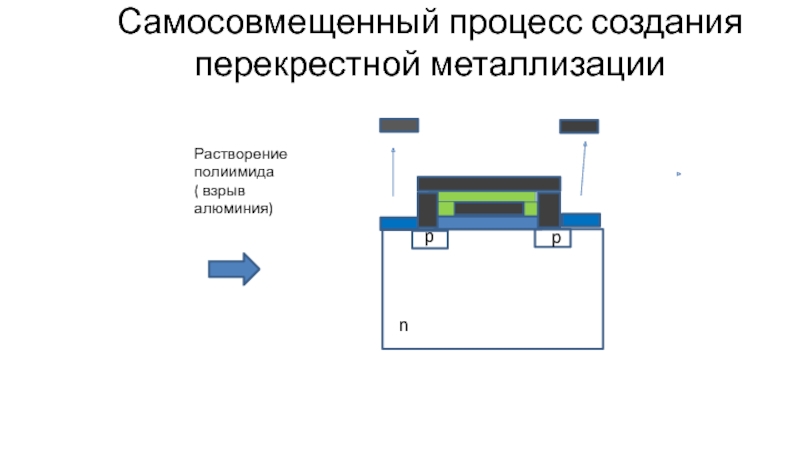
![Фундаментальные физические ограничения уменьшения размеров[1]](/img/tmb/4/368620/59889b956fa835471bb8f753ee414a01-800x.jpg)





