- Главная
- Разное
- Дизайн
- Бизнес и предпринимательство
- Аналитика
- Образование
- Развлечения
- Красота и здоровье
- Финансы
- Государство
- Путешествия
- Спорт
- Недвижимость
- Армия
- Графика
- Культурология
- Еда и кулинария
- Лингвистика
- Английский язык
- Астрономия
- Алгебра
- Биология
- География
- Детские презентации
- Информатика
- История
- Литература
- Маркетинг
- Математика
- Медицина
- Менеджмент
- Музыка
- МХК
- Немецкий язык
- ОБЖ
- Обществознание
- Окружающий мир
- Педагогика
- Русский язык
- Технология
- Физика
- Философия
- Химия
- Шаблоны, картинки для презентаций
- Экология
- Экономика
- Юриспруденция
Б.Г.ГольденбергLIGA-технология: базовые принципы и применение презентация
Содержание
- 1. Б.Г.ГольденбергLIGA-технология: базовые принципы и применение
- 2. СИ – уникальный технологический инструмент ВЭПП-3 Е= 2 ГэВ Н= 20 кГс
- 3. + коллимированность + интенсивность + проникающая способность
- 4. СИ – уникальный технологический инструмент аналитические приложения: РФА, МУРР, EXAFS… технологические приложения: рентгеновская литография
- 5. Рентгенолитография: Воздействие СИ на полимеры Полиметилметакрилат (позитивный)
- 6. Рентгенолитография: Воздействие СИ на ПММА kJ/cm3 Mw, g/mol Зависимость растворимости ПММА от дозы облучения
- 7. Рентгенолитография: полиметилметакрилат (ПММА) Позитивный
- 8. Рентгенолитография: полиметилметакрилат (ПММА) Позитивный
- 9. Рентгенолитография: 1 2
- 10. LIGA=Lithografie+Galvanik+Abformung
- 11. Изготовление микроструктур LIGA-процесс был разработан в 1980-х
- 12. Микросистемная техника Термо-пневматический насос Измеритель потока
- 13. Микросистемная техника Микрофлюидные модули Abhishek K Agarwal.
- 14. Микросистемная техника Формирование в ПММА линзы Френеля
- 15. Изготовление микроструктур 50 мкм 50 мкм Станки
- 16. Изготовление микроструктур электронная литография, Е=30 кэВ минимальные размеры:
- 17. Изготовление микроструктур фотолитография УФ λ=3650 А минимальные
- 18. Чистая комната: класс 5 ISO
- 19. Чистая комната:
- 20. Чистая комната: Установка полирования POLI-100 чистка планаризация полировка
- 21. Чистая комната: центрифуга Spincoater Model P - 6708D нанесение полимерных пленок до 100 мкм
- 22. Чистая комната: установка плазмохимии и магнетронного напыления BookEdwards и вакуумная печь
- 23. Чистая комната: участок оптической и электронной микроскопии
- 24. Схема станции LIGA на канале вывода СИ
- 25. Внешний вид и компоновка станции LIGA на
- 26. компоновка внутреннего объема станции LIGA на
- 27. Расчетное спектральное распределение мощности СИ, поглощенной в
- 28. Общий вид станции ГРЛ КИСИ, Москва. [http://www.kcsr.kiae.ru/stations/k6.3.php]
- 29. Рентгеношаблон– рисунок из рентгенопоглощающего материала на подложке
- 30. Основные этапы изготовления рентгеношаблона :
- 31. а) Электронная литография в 3 мкм резисте
- 32. Формирование структуры РШ в ИЯФ СО РАН
- 33. SU-8
- 34. Формирование структуры РШ с помощью фотолитографии Фотолитографическое
- 35. Рентгенолучевой микролитограф для формирования заготовки рентгеношаблона Способ
- 36. SU-8
- 37. Тестирование рентгеношаблонов При изготовлении рентгеношаблонов необходимо контролировать
- 38. Дополнительная проверка качества РШ проводилась с использованием
- 39. Толщина Au ~22mkm Фотографии рентгеношаблонов, полученные на
- 41. Изображение пучка СИ на запоминающем
- 43. 2. мультиплицирование
- 44. 3. Рентгеновский микролитограф
- 46. пробег фотоэлектронов Reznikova E, Mohr
- 47. LIGA – технология: задачи: изготовление высокоаспектных
- 48. Пример высокоаспектных структур из SU-8, полученных с
- 49. СЭМ фотографии фрагментов микроканальных модулей из ПММА
- 50. Формирование в ПММА линзы Френеля с глубоким
- 51. Сочетание возможности рентгенолитографически формировать микроструктуры в
- 52. Спасибо за внимание !
- 54. Принципы LIGA-технологии
Слайд 3+ коллимированность
+ интенсивность
+ проникающая способность
+ непрерывный спектр
+ расчет спектрально-угловых
СИ – уникальный технологический инструмент
~ 0.2 мрад
~ 1-10 Вт/см2 на раст. 20 м
>1 мм
УФ λ=3650 А
СИ
λ=2 А
Слайд 4СИ – уникальный технологический инструмент
аналитические приложения: РФА, МУРР, EXAFS…
технологические приложения: рентгеновская
Слайд 5Рентгенолитография:
Воздействие СИ на полимеры
Полиметилметакрилат (позитивный)
C
H
2
O
C
C
H
3
C
O
C
H
3
C
H
2
C
H
2
O
C
C
H
3
C
O
C
H
3
C
H
2
C
O
2
C
H
3
C
H
4
, C
H
3
O
H
C
O
2
, C
O
C
H
2
C
C
H
3
C
H
2
C
H
2
C
C
H
3
C
H
2
e
-
e
-
e
-
C
H
2
C
C
H
3
C
O
C
H
3
O
C
H
2
O
C
C
H
3
C
O
C
H
3
C
H
2
O
C
H
рентген, е-, е+,
}
C
3
2
C
O
H
C
C
3
H
1
2
1
2
Слайд 6Рентгенолитография:
Воздействие СИ на ПММА
kJ/cm3
Mw, g/mol
Зависимость растворимости ПММА от дозы облучения
Слайд 7
Рентгенолитография:
полиметилметакрилат (ПММА)
Позитивный резист
SU-8 (производства Microchem)
Негативный резист
доза для формирования структуры
ПММА
3500 Дж/см3 30 Дж/см3
Минимальная доза 700 Дж/см3 1 Дж/см3
*
контраст
К>50
Нормализованная толщина
Слайд 8
Рентгенолитография:
полиметилметакрилат (ПММА)
Позитивный резист
SU-8 (производства Microchem)
Негативный резист
*
Нормализованная толщина
Оптимизация резистов: чувствительность, однородность
Слайд 11Изготовление микроструктур
LIGA-процесс был разработан в 1980-х гг в IMT Forschungszentrum Karlsruhe
LIGA-процесс - метод изготовления глубоких микроструктур посредством последовательного применения глубокой рентгенолитографии, микрогальванопластики и формовки.
Слайд 12Микросистемная техника
Термо-пневматический
насос
Измеритель потока
Призматические и параболические
Линзы для рентгеновского излучения
http://www.imt.kit.edu
Элементы прецизионной микромеханики
http://micro-works.de/products.html
Слайд 13Микросистемная техника
Микрофлюидные модули
Abhishek K Agarwal. et.al.
J. Micromech. Microeng. 16 (2006)
характерные размеры структур: 10-100 мкм высота 10-1000 мкм
минимальные размеры элементов: 1-10 мкм
шероховатость : ~ 10 нм !!!
электромагнитные устройства
Слайд 14Микросистемная техника
Формирование в ПММА линзы Френеля с глубоким (до 15 мкм)
Слайд 17Изготовление микроструктур
фотолитография
УФ λ=3650 А
минимальные размеры: < 1-5мкм
высота ~10 мкм
дифракция!!!
Слайд 18Чистая комната: класс 5 ISO
чистка подложек
обработка резистов
Плазмохимия электронное и магнетронное нанесение
установка микрополирования
СЭМ Hitachi S3400N
Технологический комплекс LIGA в ИЯФ СО РАН:
центрифуга
Слайд 21Чистая комната: центрифуга Spincoater Model P - 6708D нанесение полимерных пленок до
Слайд 22Чистая комната: установка плазмохимии и магнетронного напыления BookEdwards и вакуумная печь
Слайд 24Схема станции LIGA на канале вывода СИ из накопителя ВЭПП-3
Технологический комплекс
Слайд 25Внешний вид и компоновка станции LIGA на канале вывода СИ из
Станция LIGA ВЭПП-3
Слайд 26компоновка внутреннего объема станции LIGA
на канале вывода СИ из накопителя
входное окно (Ве 300 мкм)
Держатель рентгеношаблона
XYZ координатный столик
Держатель облучаемого образца
XYφ координатный столик
видеокамера
Станция LIGA ВЭПП-3
СИ
Слайд 27Расчетное спектральное распределение мощности СИ, поглощенной в резисте ПММА
в медианной плоскости
Е=2 ГэВ, Н=20 кГс, I=100 mA
Синхротронное излучение для LIGA
Слайд 28Общий вид станции ГРЛ
КИСИ, Москва.
[http://www.kcsr.kiae.ru/stations/k6.3.php]
Станция экспонирования DEX02 производства JenOptik GmbH, Jena,
LIGA-станции в иных центрах СИ
Слайд 29Рентгеношаблон– рисунок из рентгенопоглощающего материала на подложке прозрачной для рентгеновского излучения
подложка шаблона
поглотитель
Создание и исследование рентгеношаблонов для ГРЛ
? выбор материалов подложки, резистов, поглотителя;
? формирование рисунка микроструктуры;
? формирование рентгеноконтрастного покрытия.
Слайд 30Основные этапы изготовления рентгеношаблона :
формирование резистивной маски на проводящей
электрохимическое осаждение поглощающего слоя.
Полимерная маска на подложке
Гальванопластика
золота
Создание и исследование рентгеношаблонов для ГРЛ
Слайд 31а) Электронная литография в 3 мкм резисте ПММА
Изготовление промежуточного рентгеношаблона в IMT/KIT
осаждается 2.2 мкм слой золота и удаляется оставшийся резист.
[ http://x-ray-optics.de ]
в) рентгенолитография в «мягком» СИ через промежуточный РШ в 60 мкм слой резиста ПММА на титановой подложке;
г) проявления резиста гальванически осаждается 25 мкм слой золота на подложку из 2 мкм титана и удаляется оставшийся резист
Изготовление рентгеношаблонов для ГРЛ
в IMT/KIT, Karlsrue (Germany)
Слайд 33
SU-8
стеклоуглерод
ИЯФ: Формирование структуры РШ
с помощью
Фотошаблон
ИФП СО РАН, ИАиЭ СО РАН
Слайд 34Формирование структуры РШ
с помощью фотолитографии
Фотолитографическое формирование струкутры шаблона:
+ простота
+ низкая себестоимость
-
Re SU-8
10 мкм
Слайд 35Рентгенолучевой микролитограф для формирования заготовки рентгеношаблона
Способ рентгенолучевого формирования топологи РШ для
без использования дорогостоящих этапов электронной литографии, изготовления промежуточного рентгеношаблона и рентгенолитографии в «мягком» спектре СИ для получения рабочего РШ
Слайд 36SU-8
50 мкм
29 мкм
SU-8
Au 20 мкм
Фрагмент заготовки рентгеношаблона – микроструктура из резиста SU-8 высотой 29 мкм на подложке из стеклоуглерода
Рентгеношаблон после осаждения на заготовку слоя золота
гладкие стенки!
прямые углы!
Формирование структуры РШ
рентгенолучевым методом
60 мкм
Слайд 37Тестирование рентгеношаблонов
При изготовлении рентгеношаблонов необходимо контролировать такие основные параметры как:
качество рисунка
состав рентгенопоглощающего слоя;
контраст РШ.
Контроль рисунка микроструктуры и элементного состава поглощающего слоя осуществлялся с использованием сканирующего электронного микроскопа. Однако СЭМ-изображение не дает информации о внутренних дефектах и контрасте шаблона.
Слайд 38Дополнительная проверка качества РШ проводилась с использованием монохроматического СИ (λ=1.13 Å)
На рентгеновских микроснимках дефектные участки с недостаточным контрастом представляются светлыми пятнами в темном рентгеноконтрастном поле, а контраст изображения соответствует контрасту рентгеношаблона в данном спектре. Пространственное разрешение микроскопии 2 мкм.
Тестирование рентгеношаблонов на станции «рентгеновской микроскопии и томографии» ВЭПП-3
Au
Пример исследования рентгеноконтраста шаблона
пропускание %
[Гольденберг Б.Г., Купер К.Э., Кондратьев В.И. и др. Экспресс-метод контроля рентгеношаблонов для глубокой рентгенолитографии // XVIII международная конференция по использованию синхротронного излучения, СИ-2010]
Слайд 39Толщина Au ~22mkm
Фотографии рентгеношаблонов, полученные на СЭМ Hitachi S3400N
Изображение, полученное на
недостаточный контраст
Тестирование рентгеношаблонов на станции «рентгеновской микроскопии»
Au
SU-8
Au
SU-8
Контраст λ=1.13A ~5
Толщина Au ~ 9 mkm
Контраст λ=1.13A ~50
Слайд 40
1. сканирование 2. мультиплицирование
3. Рентгеновский микролитограф 4.
Режимы экспонирования
Слайд 41
Изображение пучка СИ на запоминающем экране Image Plate© и его оцифровка
Вертикальное
Генцелев А.Н., Гольденберг Б.Г., Кондратьев В.И. и др. LIGA-станция на накопителе ВЭПП-3 // Поверхность. - 2002. - № 9. - С. 30-35.
Распределение интенсивности СИ на LIGA-станции
4.6 мм
Слайд 42
1. сканирование
Режимы экспонирования
Испольуется при облучении образцов, площадь которых больше
Резист и шаблон в единной сборке возратно-поступательно качаются поперек пучка СИ
однородная усредненная доза по всей площади
снижение тепловых нагрузок на образец
Слайд 43
2. мультиплицирование
Режимы экспонирования
многократное повторение элементарного рисунка «ячейки» по большому
После каждой экспозиции подложка смещается отностительно фиксированного шаблона на заданный шаг и экспозиция повторяется
Слайд 44
3. Рентгеновский микролитограф
Режимы экспонирования
Коллимированный луч СИ используется как «перо» для
Слайд 45
4. динамическая литография
Режимы экспонирования
Скорость растворения облученного позитивного резиста пропорциональна полученной
Двигая резист во время облучения относительно шаблона можно добиться неоднородного распределения дозы => 3D профиль
СИ
Слайд 46пробег фотоэлектронов
Reznikova E, Mohr J, Boerner M, et.al. // 2008.
дифракционное разрешение
суммарное отклонение
Влияние дифракции и вторичных электронов на разрешающую способность
ограничение разрешающей способности
Слайд 47LIGA – технология:
задачи: изготовление высокоаспектных микроструктур с уникальными параметрами:
- Минимальные размеры
- глубина/высота до 1000 мкм
- шероховатость от 10 нм
технологические этапы: *глубокая рентгенолитография
*гальванопластика
*штамповка
*литьё
обеспечения - источник СИ – накопитель электронов
- автоматизированная станция экспонирования
- участок химической подготовки и обработки
- участок контроля
- изготовление рентгеношаблонов
Слайд 48Пример высокоаспектных структур из SU-8, полученных с использованием созданного рентгеношаблона.
Высота
ширина линии 40 мкм.
Примеры изготовления микроструктур методом глубокой рентгенолитографии в ИЯФ СО РАН
Слайд 49СЭМ фотографии фрагментов микроканальных модулей из ПММА
Ширина и глубина
Изготовление микроструктур методом глубокой рентгенолитографии
микрофлюидные системы для экспресс анализа (совместно с ИЦиГ СО РАН)
Слайд 50Формирование в ПММА линзы Френеля с глубоким (до 15 мкм) микрорельефом
Изготовление микроструктур методом глубокой рентгенолитографии
Микропрофилированные оптические элементы
(совместно с ИАиЭ СО РАН)
Слайд 51
Сочетание возможности рентгенолитографически формировать микроструктуры в толстых полимерных пленках (100-1000 мкм)
Изготовление микроструктур методом глубокой рентгенолитографии
Элементы квазиоптики для излучения ТГц-диапазона
[ Генцелев А.Н., Гольденберг Б.Г., Зелинский А.Г.,…Кузнецов С.А. и др. Применение LIGA для создания селективных элементов ТГц-диапазона – металлических и псевдометаллических толстых сеточных структур // Рабочее совещание «Рентгеновская оптика – 2010», г. Черноголовка]
Слайд 54Принципы LIGA-технологии
LIGA – акроним, составленный из немецких слов:
Litographie,
Galvanoformung
Abformung
литография, гальваника, формовка
http://x-ray-optics.de
Основной процесс LIGA это глубокая рентгеновская литография (ГРЛ) на синхротронном излучении (СИ).
h = 100-1000 мкм
~ 1 мкм
~ 10 нм
вертикальные стенки


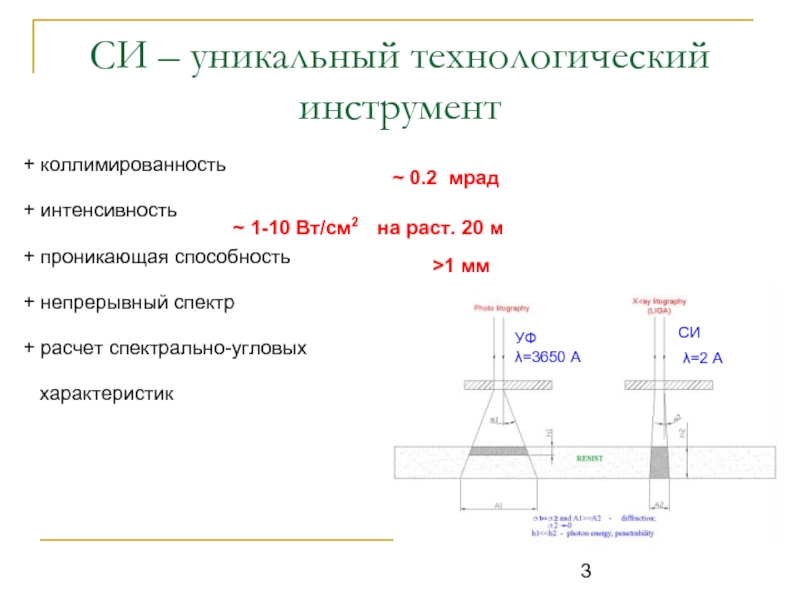

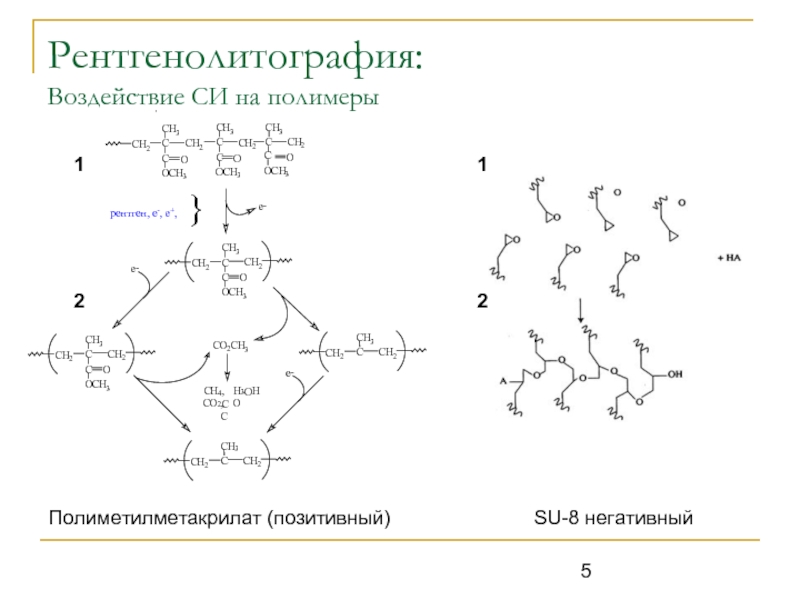
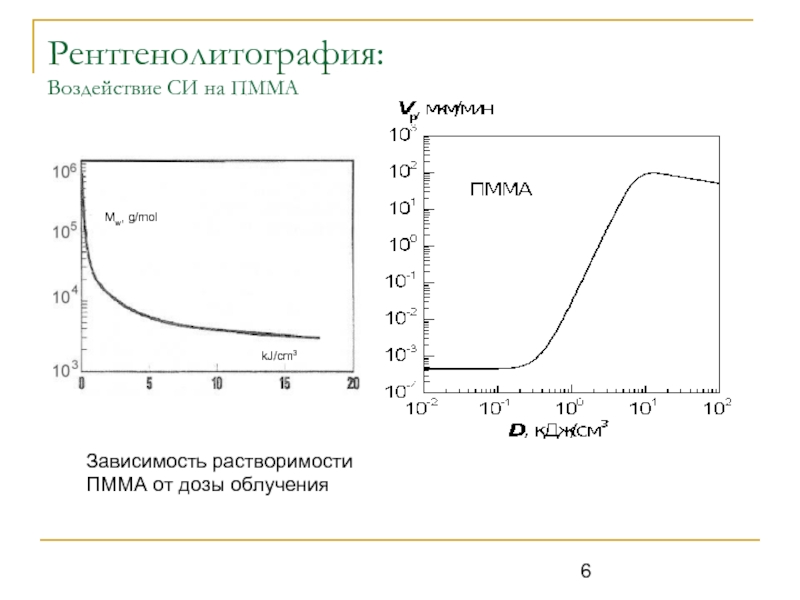
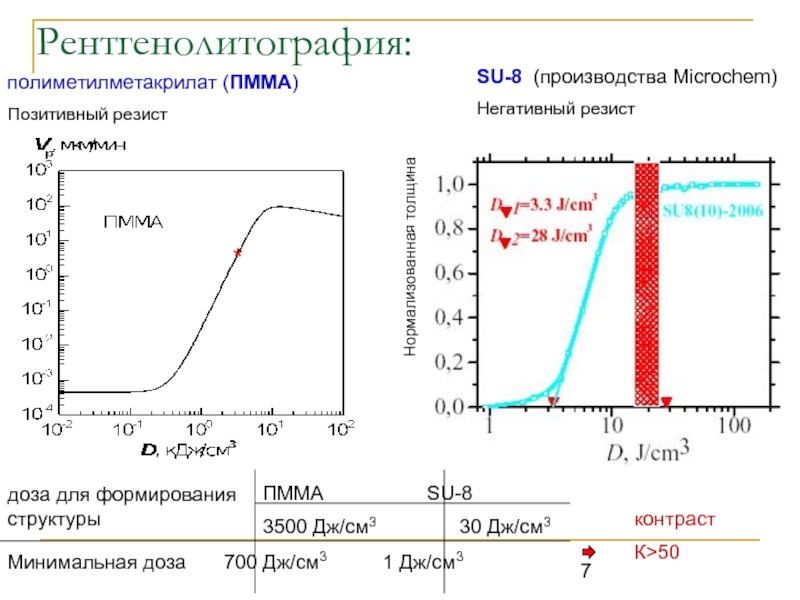
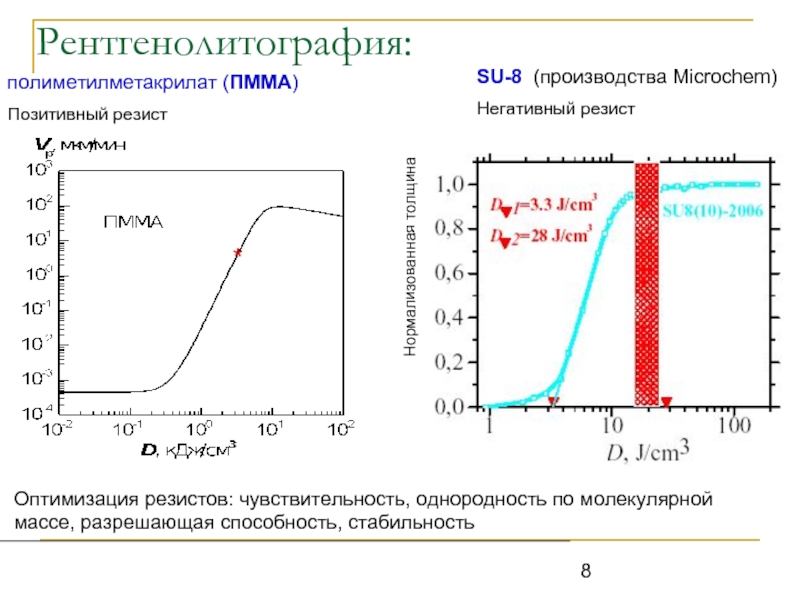

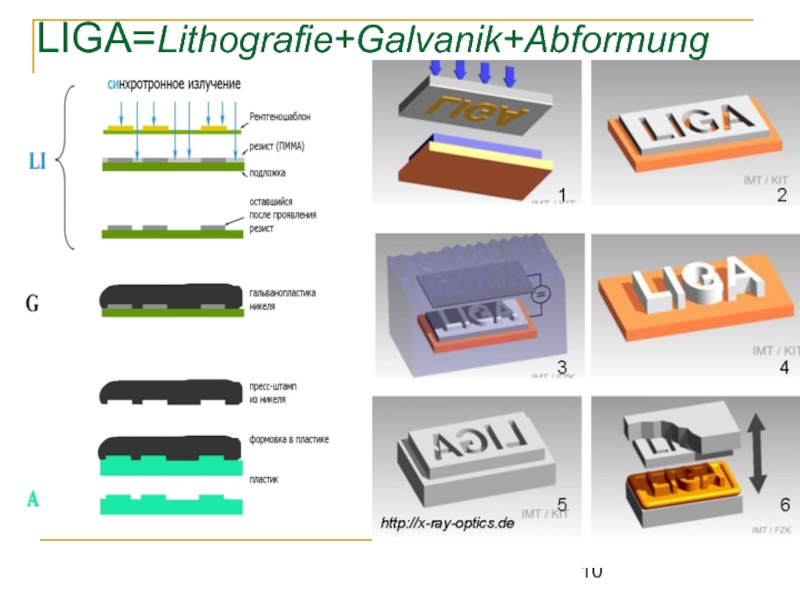




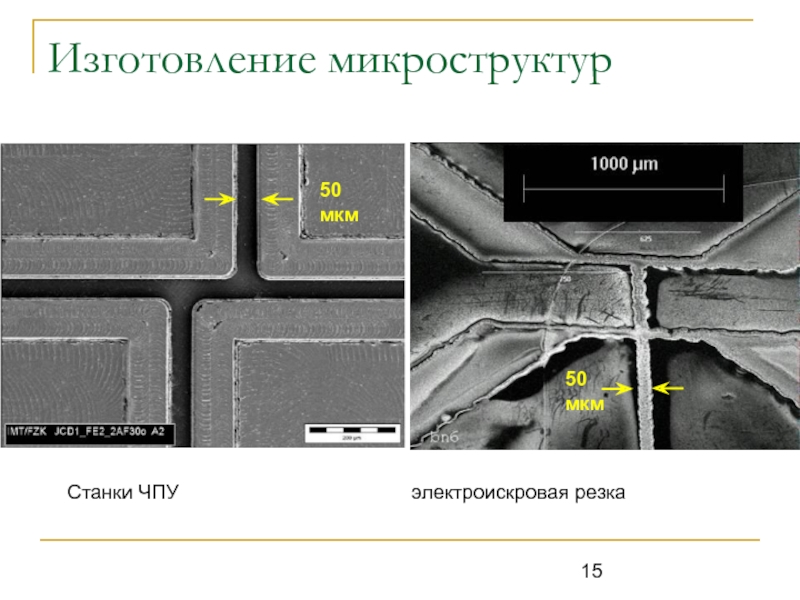




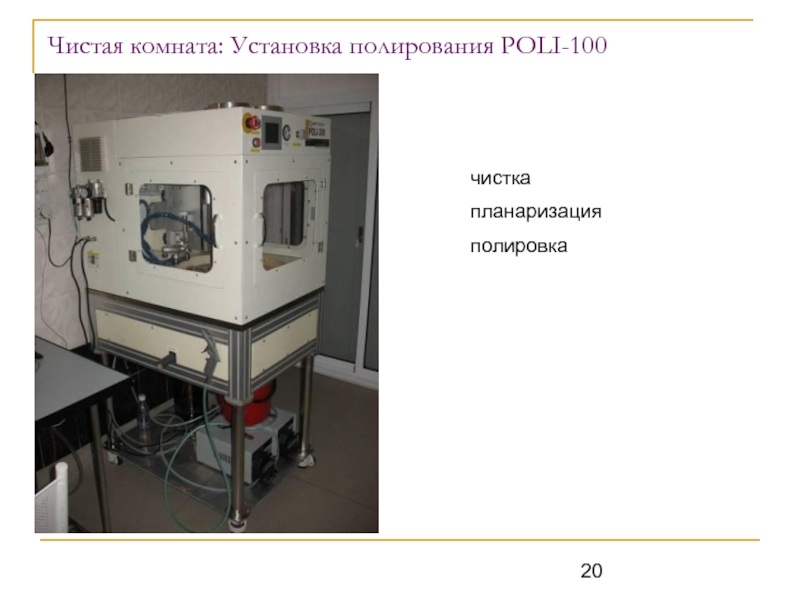
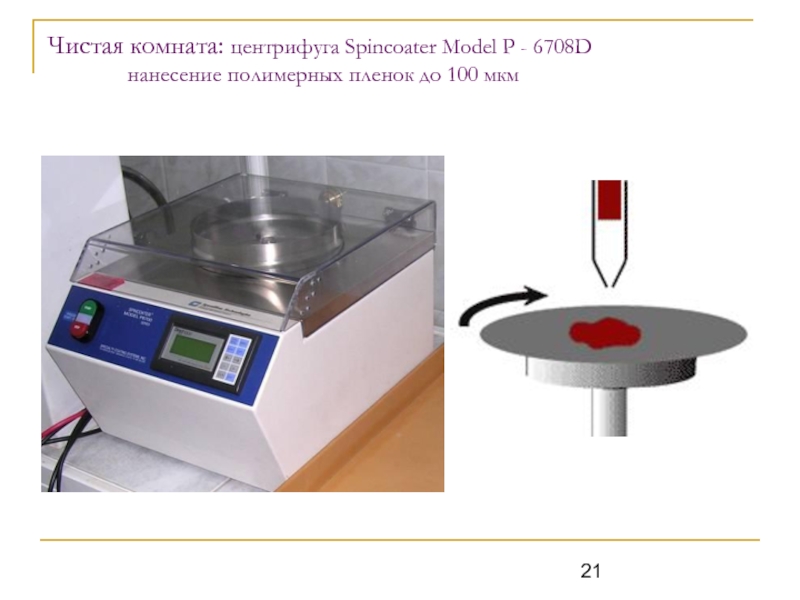


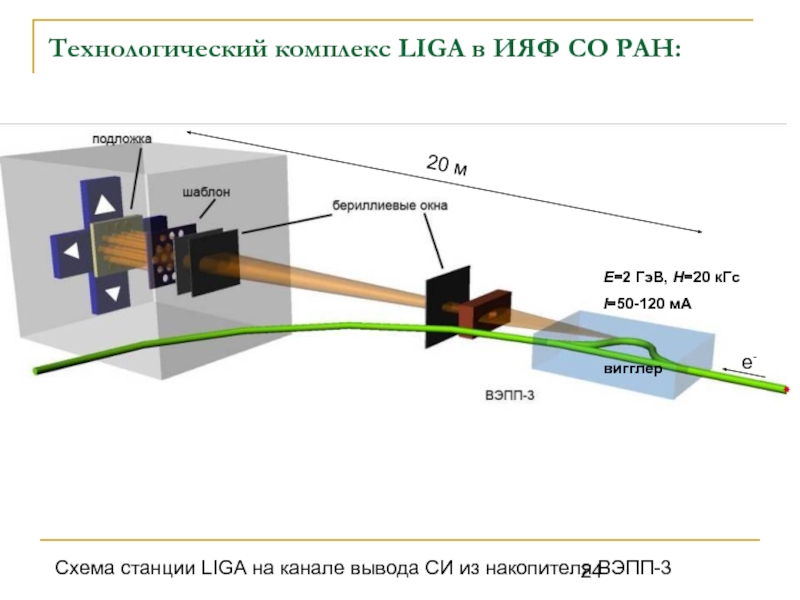



![Общий вид станции ГРЛКИСИ, Москва.[http://www.kcsr.kiae.ru/stations/k6.3.php]Станция экспонирования DEX02 производства JenOptik GmbH, Jena, Germany на канале LIGA-2,](/img/tmb/2/123686/9b93f55abb84ff6cca9c79b24393820a-800x.jpg)